


引言
氮化镓(GaN)具有六方纤锌矿结构,直接带隙约为3.4eV,目前已成为实现蓝光发光二极管(led)的主导材料。由于GaN的高化学稳定性,在室温下用湿法化学蚀刻来蚀刻或图案化GaN是非常困难的。与湿法蚀刻技术相比,干法蚀刻技术可以提供各向异性的轮廓、快速的蚀刻速率,并且已经被用于限定具有受控轮廓和蚀刻深度的器件特征。【兆生清洗设备】【设备】【】【晶圆清洗设备制造】
实验与讨论
我们用金属有机化学气相沉积法在(000±1)蓝宝石衬底上生长了5.2μm厚的GaN外延层,通过等离子体增强化学气相沉积(PECVD)在GaN上沉积一层800nm厚的二氧化硅硬掩模。然后将正性光致抗蚀剂AZ4620旋涂到样品上。曝光后,在光致抗蚀剂层中定义图案。然后通过基于氟的化学反应离子蚀刻(RIE)打开SiO2硬掩模,之后使用ICP蚀刻将图案从SiO2转移到GaN层中。【晶圆清洗设备制造厂家】【rca清洗设备】【】【兆生清洗设备】【湿法刻蚀设备】【晶圆清洗设备】
为了确定对二氧化硅的蚀刻速率和蚀刻选择性,使用轮廓测量法测量二氧化硅掩模的蚀刻深度。在用缓冲HF溶液剥离二氧化硅掩模之后,从轮廓术获得GaN的蚀刻深度。蚀刻速率由蚀刻深度和蚀刻时间决定。【KOH腐殖清洗机】【】【RCA清洁设备】
在保持1000W ICP/150W RF功率、70sccm总气体流量、30%Cl2/70%BCl3的同时,英思特研究了操作压力对GaN蚀刻速率的影响。由于在较低压力下反应物受限,我们发现GaN蚀刻速率随着压力的增加而增加。这是由于较高的DC偏压在反应或再沉积在蚀刻表面上之前,引发反应性等离子体物种的溅射解吸。【英思特】【】【半导体】【
图1显示出了在300W ICP/100W RF功率、70sccm总流速、90%Cl2/10%BCl3、7毫托操作条件下光刻胶掩蔽的GaN的SEM横截面显微照片。为了提高GaN对光刻胶的刻蚀选择性,ICP功率和RF功率从300W/100W增加到450W/150W。在450W ICP/150W RF功率下,GaN蚀刻速率为320nm/min,对光致抗蚀剂的蚀刻选择性为0.76。当ICP/RF功率从300W/100W增加到450W/150W时,GaN对光刻胶的蚀刻选择性从0.43提高到0.76。因此,GaN对光刻胶的蚀刻选择性强烈地依赖于ICP和RF功率。【

图1
对于深沟槽的形成,需要更高的离子通量来实现GaN的高蚀刻速率。由于对光致抗蚀剂的低选择性和光致抗蚀剂掩模的腐蚀,高RF功率经常导致侧壁和表面粗糙。我们通常使用诸如SiO2的硬掩模来代替光致抗蚀剂,因为在基于Cl2的等离子体化学中,GaN相对于SiO2的蚀刻选择性是有利的。【全自动晶圆清洗机】【RCA清洁设备】【马来西亚戈尼干炎装备】【
为了提高GaN相对于SiO2的蚀刻选择性,我们将蚀刻条件固定在1000W ICP/300W RF功率、70sccm的总流速、90%Cl2/10%BCl3、14毫托操作,如图2所示GaN对SiO2的蚀刻选择性为7.92,并且观察到更垂直的蚀刻轮廓。与之前的工艺参数相比,随着Cl2/BCl3中Cl2浓度的增加和射频功率的增加,GaN和SiO2的刻蚀速率也随之增加。【湿法刻蚀】【湿法制程设备】【湿法设备制造厂家】
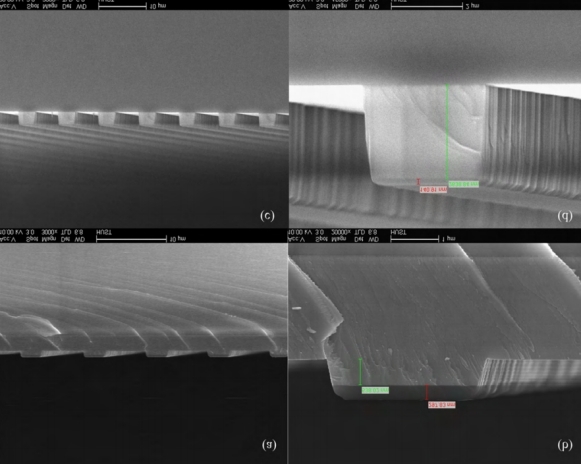
图2:二氧化硅掩蔽氮化镓样品的扫描电镜横断面显微图
结论
在本工作中,英思特使用Cl2/BCl3电感耦合等离子体研究了输入工艺参数对GaN薄膜刻蚀特性的影响。尽管较高的ICP/RF功率可以获得较高的GaN/光致抗蚀剂蚀刻选择性,但是由于光致抗蚀剂掩模腐蚀,它会导致侧壁的刻面和奇怪的侧壁轮廓。在特定的ICP/RF功率和固定的混合物成分下,GaN和SiO2的蚀刻速率会随着操作压力的增加而降低,并且由于SiO2蚀刻速率的降低比GaN蚀刻速率的降低更快,GaN对SiO2的蚀刻选择性会随着操作压力的增加而增加。【rca清洗设备】【马兰戈尼干燥设备】【兆生清洗设备】
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护,联系人吴经理,联系电话18014374656(微信同号)