引言
化学机械抛光(CMP)是目前制备铜互连过程中常用的技术。铜化学机械抛光具有表面平面化,减少工艺步骤和热预算等优点。然而,它会在介电材料表面上引起金属和有机污染物残留,由于其通过二氧化硅和硅的快速扩散,并形成供体和受体,导致铜在化学机械抛光(CMP)工艺后需要适当的清洗。此外,苯并三唑(BTA,C6H5N3)经常用于降低蚀刻速率,从而避免铜表面上的各向同性蚀刻,并确保良好的表面平坦化。BTA是一种有机污染物,会降低后续工艺的集成度。【设备】【设备】【】【晶圆清洗设备制造】【晶圆清洗设备制造厂家】
铜化学机械抛光是一个复杂的过程,它会引起许多不良影响,为了调查Cu和BTA污染的影响,采用了使用硫酸铜和BTA溶液的故意污染法。【】【】【兆声清洗设备】【湿法刻蚀设备】【晶圆清洗设备】【KOH腐殖清洗机】
实验与讨论
本研究使用了两种HAL BHF溶液:HAL 4006和HAL 4025。HAL 4006的组成是0.2%氟化氢(HF)和40%氟化铵(NH4F),外加表面活性剂;而HAL 4025是0.7% 氟化氢(HF)和40% 氟化铵(NH4F),外加表面活性剂。臭氧水中含有10和15ppm的浓度。为了模拟CMP工艺后所暴露的晶片表面,我们在电阻率为15-25Ω·cm的p型Si(100)晶片上沉积电介质和Cu层。对于介电层样品,用RCA初始清洗法来清洗晶片,然后在硅上沉积2000A˚TEOS氧化物。
对于铜层样品,用预沉积的2000A˚TEOS氧化物溅射厚度为2000A˚/1000A˚。图1显示了MOS电容器的制造工艺流程。MOS电容直径为400 mm,通过MOS电容分析了漏电流密度、击穿电场和电荷击穿特性。【】【RCA清洁设备】【英思特】【】【半导体】【湿法制程】
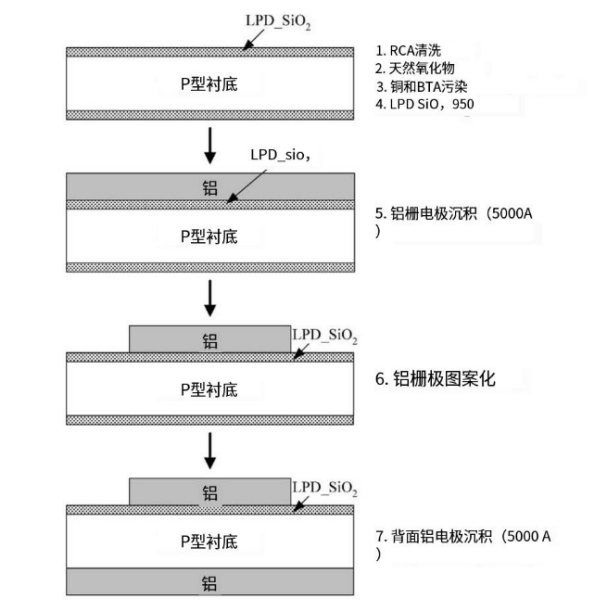
图1:LPD MOS电容器的制造工艺流程
众所周知,氧化物粗糙度在漏电流和击穿电场的控制中很重要。如果清洗后的氧化物表面是粗糙的,那么由于急剧的弯曲引起的局部电场增强将会降低漏电流和击穿性能。我们比较了哈尔BHF溶液和常规的0.5%柠檬酸溶液清洗的粗糙度性能。图2显示了用不同溶液清洗后的TEOS氧化物和铜表面粗糙度。【江苏英思特半导体科技有限公司】【湿法制程设备】【晶圆清洁设备】
从实验结果来看,HAL 4006和HAL 4025溶液清洗改善了TEOS氧化物和铜的表面粗糙度,也表现出比0.5%柠檬酸溶液清洗更好的性能。氢氟酸会轻微腐蚀氧化物和铜表面,HAL 4006和HAL 4025溶液中的表面活性剂有助于在清洗过程中平滑表面。由于缺乏表面活性剂,0.5%的柠檬酸溶液清洗不能达到比哈尔BHF溶液更好的粗糙性能。【RCA清洗机】【KOH腐殖清洗机】【全自动晶圆清洗机】【RCA清洁设备】【马来西亚戈尼干炎装备】

图2:原子力显微镜(AFM)中粗糙度分析
结论
英思特提出了一种新的清洗技术,包括HAL BHF溶液和后续的O3水清洗。根据AFM研究,HAL BHF溶液在铜和金属间介质(IMD)表面上显示出比传统的0.5%柠檬酸溶液更好的光滑度。关于减少金属间介质(IMD)表面上的铜和BTA污染,我们发现哈尔BHF溶液在氧化物表面上具有较低的污染残留物。其高清洗性能可归因于:(1)表面活性剂在哈尔BHF溶液中的表面平滑作用;(2)BHF的蚀刻效应;(3)O3水的清洁效率。从实验结果来看,HAL BHF和O3水可以有效地去除CMP后清洗过程中的Cu和BTA污染。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护,联系人吴经理,联系电话18014374656(微信同号)



